
電氣故障分析
ELITE 系統
鎖相紅外線熱成像系統,其增強鎖相熱發射功能用於定位半導體元件中的缺陷。

先進的封裝應用、複雜的互連方案和更高效能的功率元件的快速成長給故障定位和分析帶來了前所未有的挑戰。 有缺陷或性能不佳的半導體裝置通常表現出局部功率損耗的異常分佈,導致局部溫度升高。 Thermo Scientific ELITE 系統利用鎖相紅外線熱成像 (LIT) 進行半導體裝置故障定位,可以準確有效地定位這些目標區域。
LIT 是一種動態紅外線熱成像形式,與穩態熱成像相比,其可提供更好的信噪比、更高的靈敏度和更高的特徵解析度。 LIT 可在 IC 半導體失效分析中用於定位線路短路、ESD 缺陷、氧化損壞、缺陷電晶體和二極體以及裝置閂鎖。 LIT 可在自然環境中進行,無需光屏蔽箱。
鎖相紅外線熱成像系統的功能:
- 市售極高靈敏度熱發射系統
- 即時鎖相測量
- 幾秒鐘後溫差解析度 < 1 mK ;幾小時後 < 10 μK
- 非接觸絕對溫度測繪
- 完全封裝與堆疊裸片分析
- 六 位轉輪,帶有針對 MWIR 發射優化的客製化透鏡
ELITE的主要特點
堆疊晶片分析
堆疊裸片給分析員帶來了獨特的挑戰 。 處理黏合或 TSV 晶片堆疊時,LIT 可用於定位完全封裝的裝置上晶片堆疊內 X、Y 和 Z 深度的缺陷。
採集時間越長,靈敏度越高
系統採集資料的時間越長,靈敏度越高。 當試圖以極低的功率級擷取資料或必須從弱故障模式中擷取資料時,鎖相紅外線熱成像ELITE 系統的這項特性尤其有價值。
"無限制"資料累積時間,可獲得更好的分辨率
鎖相頻率越高,所得到的空間解析度則越高。 然而,對於鎖相紅外線熱成像系統來說,較高的頻率往往會顯著降低待偵測的熱發射。 這是許多 LIT 系統的限制。 ELITE 系統透過提供一個獨特的系統架構克服了這個限制,在該架構中,可以在"無限"的時間內累積更高頻率的 LIT 資料。 數據採集持續延長,數據解析度提高。
可選透鏡靈活性
鎖相紅外線熱成像ELITE 系統可採用單透鏡和相機配置,也具有 6 位元轉輪的靈活性。 提供多種客製化、高品質 MWIR 顯微鏡物鏡,包括:28 mm 廣角、1x、5x 和 10x 可獲得 20x 的有效放大率,同時結合 640 InSb 相機的 15 μm 像素間距 。
ELITE 系統的規格
| 横向分辨率 |
|
| 深度分辨率 |
|
| 缺陷類型 |
|
| 樣品類型 |
|
| FOV |
|
| DUT 刺激 |
|
| 獲得結果時間 |
|
鎖相紅外線熱成像系統相關資源

ELITE 系統具有 3D 定位熱源的能力,非常適合堆疊晶片分析。

靈敏度隨功率級不同而變化。
ELITE系統相關應用

半導體探索與開發
先進的電子顯微鏡、聚焦離子束和相關半導體分析技術可用於識別製造高性能半導體裝置的可行解決方案和設計方法。

良率提升與計量
我們為缺陷分析、計量學和製程控制提供先進的分析功能,旨在幫助提高生產率並改善一系列半導體應用和設備的產量。

半導體故障分析
越來越複雜的半導體裝置結構導致更多隱藏故障引起的缺陷的位置。 我們的新一代半導體分析工作流程可協助您定位和表徵影響量產、性能和可靠性的細微的電子問題

物理和化學表徵
持續的消費者需求推動了創造更小型、更快、更便宜的電子設備。 它們的生產依賴高效的儀器和工作流程,可對多種半導體和顯示設備進行電子顯微鏡成像、分析和表徵。

ESD 半導體鑑定
每個靜電放電 (ESD) 控制計劃都必須識別對 ESD 敏感的裝置。 我們提供一整套ESD測試系統,協助滿足您的裝置鑑定要求。
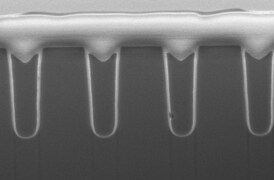
電源半導體設備分析
電源設備讓定位故障面臨獨特的挑戰,主要是因為電源設備結構和佈局。 我們的電源設備分析工具和工作流程可在工作條件下快速實現故障定位並提供精確、高通量的分析,以便表徵材料、介面和設備結構

顯示設備故障分析
不斷發展的顯示技術旨在提高顯示品質和光轉換效率,以支援不同產業領域的應用,同時繼續降低生產成本。 我們的流程計量、故障分析和研發解決方案可協助顯示公司解決這些挑戰。

X射線檢查確認
圖1: 所示 異物導致主機板內部短路-在主機板上(左圖),ELITE在5分鐘內觀察到一個通孔中的熱點。 x射線測量(右圖)得出結論,通孔之間的異物導致了短路失效。

SEM檢查確認
圖2: WLCSP跌落試驗導致焊球斷裂-WLCSP JEDEC板跌落試驗後鑑定,電阻從< 1 Ω增加到6 Ω。 ELITE系統在4分鐘內就在WLCSP上發現了一個熱點,掃描電子顯微鏡證實了焊球中有裂縫。
SEM confirmation:SEM檢查確認

X射線檢查確認
圖3: 引線框架封裝內發現枝晶-封裝部分經過2000小時高溫、高濕試驗後出現小洩漏。 ELITE系統發現沒有開封的塑封體內有熱點。 x光檢查發現枝晶是根本原因。

圖4: 使用10倍MWIR鏡頭的晶片級分析,SIL和S-LSM選項具有卓越的成像和最高的分辨率,可用於精確導航和定位。




















.png)

.png)




















.png)







